플라즈마 CVD란?
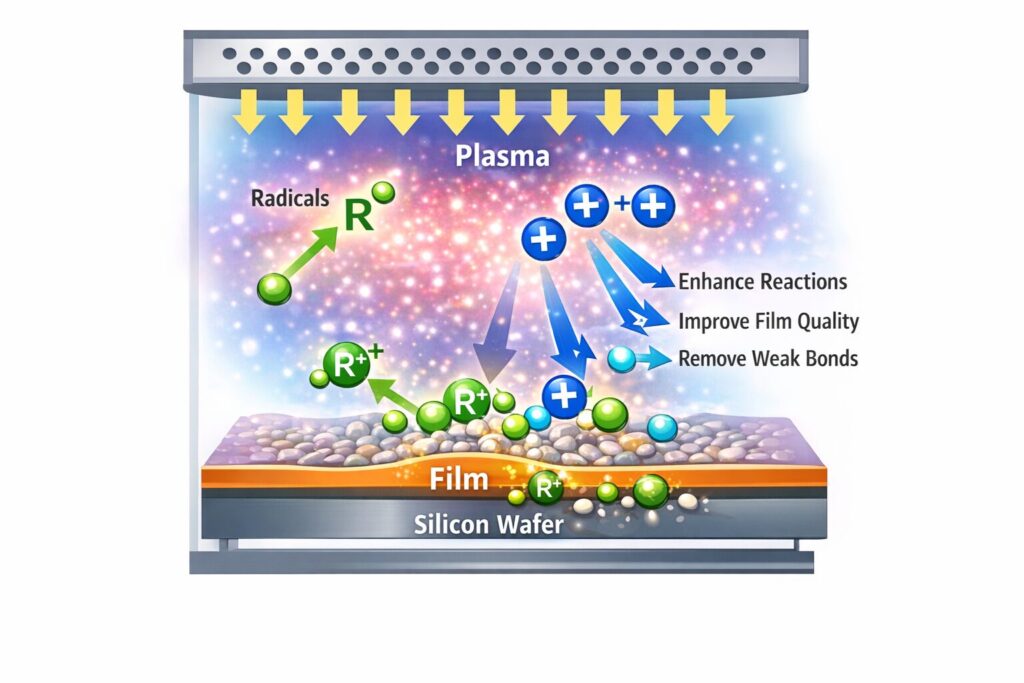
박막 형성에서는 재료를 기판 위에 균일하게 쌓아 올리는 것이 중요합니다. 플라즈마 CVD는 원료 가스를 플라즈마로 활성화하고, 기판 표면에서 화학 반응을 일으켜 박막을 형성하는 방법입니다.
반응을 주로 열로 진행시키는 일반적인 CVD와 비교하면, 플라즈마 CVD는 비교적 낮은 온도에서도 반응을 진행시키기 쉽습니다. 이 때문에 반도체막, 절연막, 보호막 등의 형성에 널리 사용됩니다.



이번에는 PIC-PLASMA 3D(플라즈마 해석 소프트웨어)를 사용하여 산업용 플라즈마 CVD 장치 내부의 플라즈마 분포와 기판 근방으로의 입자 도달 경향을 해석해 보겠습니다.
플라즈마 CVD 장치의 기본 원리
플라즈마 CVD 장치는 반응성 가스를 플라즈마로 활성화하여 기판 표면에 박막을 성장시키는 장치입니다. 예를 들어 SiH4, NH3, O2 등의 원료 가스를 도입하고 RF 전력을 인가하여 방전을 일으키면 이온, 전자, 라디칼이 생성됩니다.
기본 원리는 다음과 같습니다.
- 진공 챔버 내부에 원료 가스와 희석 가스를 도입한다
- 상부 전극 또는 샤워헤드와 하부 스테이지 사이에 고주파 전력을 인가한다
- 전자가 가스 분자와 충돌하여 이온화, 여기, 해리를 일으키고 플라즈마를 형성한다
- 생성된 라디칼과 이온이 기판 근방으로 수송된다
- 기판 표면에서 흡착, 반응, 재결합이 일어나 박막이 형성된다
라디칼의 역할: 플라즈마 중에서 생성된 중성 라디칼은 기판 표면의 화학 반응에 크게 관여합니다. 막 형성에 필요한 전구체로 작용하며, 조성과 증착 속도에 영향을 줍니다.
이온의 역할: 이온은 기판 근방의 쉬스 전계에서 가속되어 표면에 도달합니다. 지나치게 강한 이온 충격은 막 손상이나 결함 증가로 이어질 수 있는 반면, 적절한 이온 어시스트는 막질 향상과 치밀화에 기여합니다.
즉, 플라즈마 CVD에서는 화학 반응을 담당하는 라디칼 수송과 표면 상태에 영향을 주는 이온 입사를 모두 적절히 제어하는 것이 중요합니다.
플라즈마 CVD 해석에서 무엇을 보아야 하는가
플라즈마 CVD 장치에서는 증착 속도뿐 아니라 막 두께 분포, 막질, 기판 손상, 장치 내부의 반응 균일성도 중요합니다. 따라서 시뮬레이션에서는 다음과 같은 점을 파악할 가치가 있습니다.
- 챔버 내부의 플라즈마 밀도 분포
- 기판 상부의 전위 및 전기장 분포
- 이온의 도달 방향과 에너지 경향
- 가스 유입구에서 기판까지의 입자 수송 편차
- 증착 균일성에 영향을 주는 공간 분포
특히 기판 전체에 균일하게 박막을 형성하고자 할 경우, 방전 영역의 퍼짐, 샤워헤드 형상, 스테이지 위치, 챔버 치수의 균형이 중요해집니다.
플라즈마 CVD 장치 내부의 플라즈마 분포 해석
PIC-PLASMA 3D를 사용하여 플라즈마 CVD 장치 내부의 방전 영역과 기판 근방으로의 입자 수송 경향을 확인해 보겠습니다.
해석 모델
이번 해석에서는 상부에 가스 도입 기능을 겸하는 샤워헤드 전극, 하부에 기판 스테이지를 갖는 단순화된 플라즈마 CVD 반응기를 대상으로 했습니다. 제조용 상세 CAD가 아니라, 플라즈마 생성 영역, 쉬스 형성 영역, 기판 근방 영역을 파악하기 쉬운 해석용 모델을 우선했습니다.
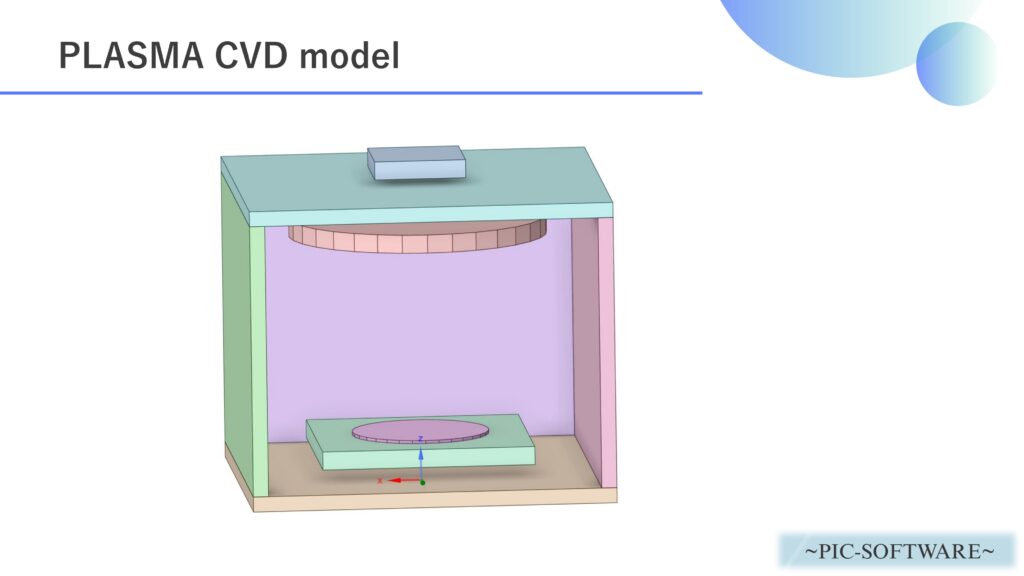
그림 1: 플라즈마 CVD 장치의 해석 모델
모델 내에서는 가스 유입구로부터 공급된 원료 가스가 상부 영역에서 방전되고, 생성된 이온, 전자, 라디칼이 기판 방향으로 수송되는 것으로 가정했습니다.

해석 조건
해석 조건은 다음과 같습니다.
| 해석 소프트웨어 | PIC-PLASMA 3D |
| 해석 유형 | 플라즈마 해석 |
| 해석 오브젝트 | plasma_cvd_reactor.obj |
| 대상 공정 | 플라즈마 CVD |
| 대표 가스종 | O2 |
| 플라즈마 밀도 | 1.0×106 [개/m3] |
| 인가 조건 | 상부 전극 RF 인가를 모사한 전위차 조건 |
| 시간 간격 | 1.0×10-8 [s] |
| 총 시뮬레이션 시간 | 2.0×10-5 [s] |
| 주요 확인 항목 | 플라즈마 분포, 전기장 분포, 기판 근방 입자 도달 경향 |
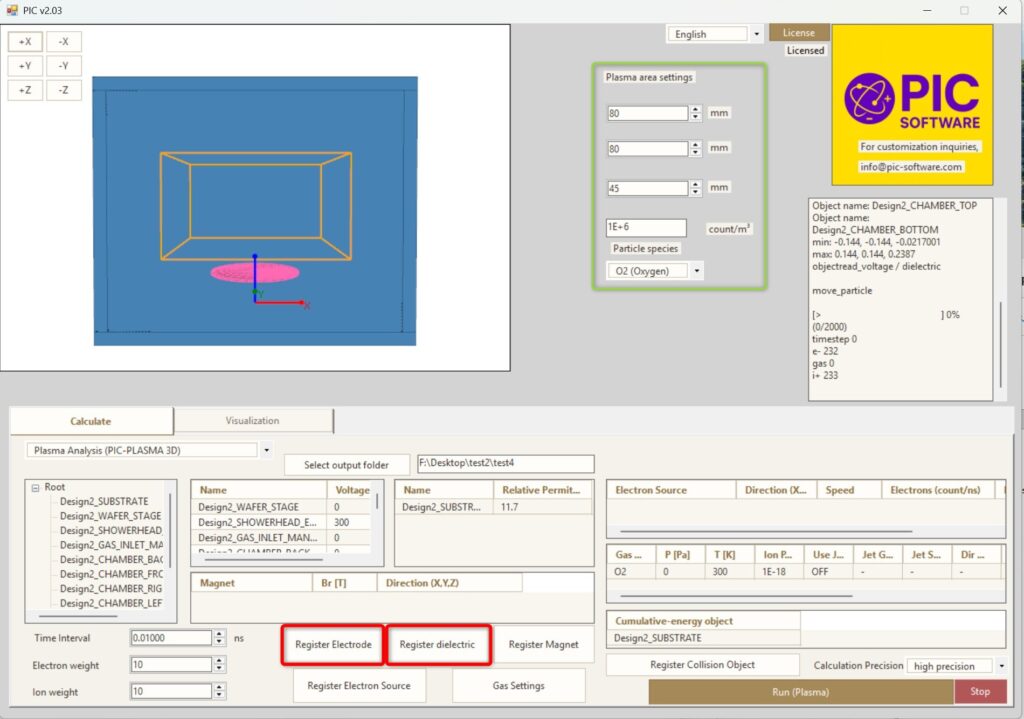
실제 증착에서는 가스 반응과 표면 반응의 상세 모델링도 중요하지만, 이번 모델에서는 우선 장치 내부의 방전 구조와 입자 수송 경향을 파악하는 것에 중점을 두고 있습니다.

해석 결과
해석 결과의 한 예로, 챔버 내부에서는 상부 샤워헤드 근방에서 기판 상부에 이르기까지 방전 영역이 형성되며, 전극 사이에 비교적 넓은 플라즈마 생성 공간이 확보되는 것을 확인할 수 있습니다.
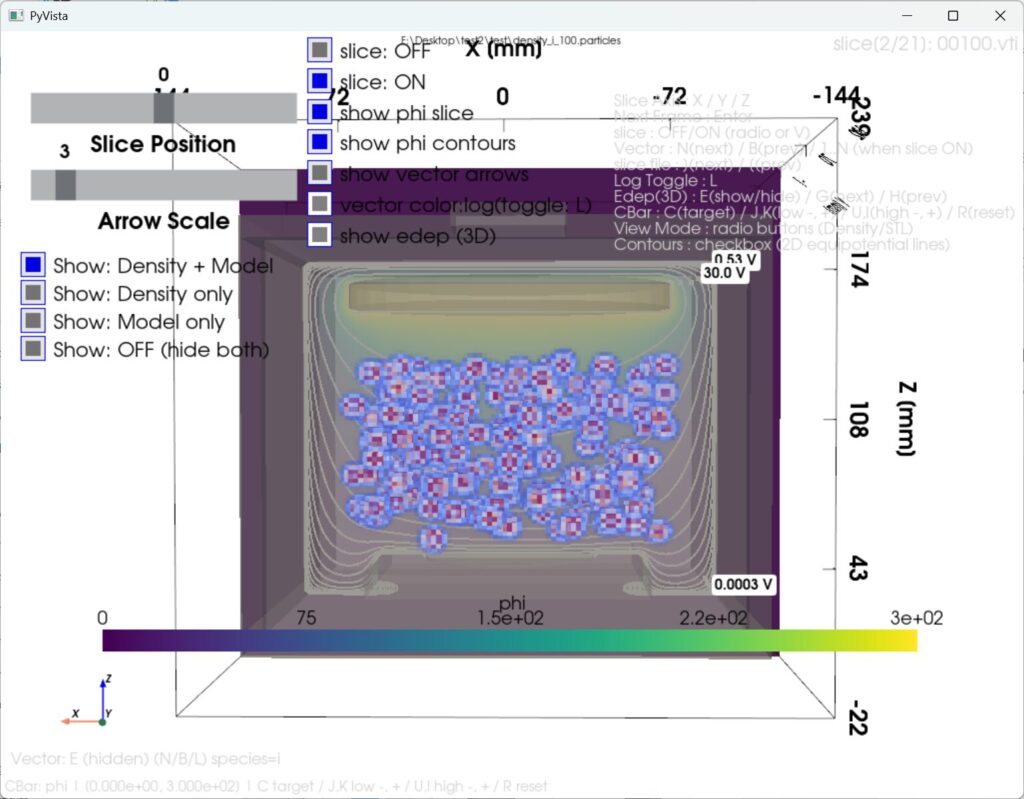
그림 2: 플라즈마 CVD 장치 내부의 이온 밀도와 전기장
또한 기판 근방에서는 쉬스 형성으로 인해 전기장이 강해지고, 이온이 기판 방향으로 더 쉽게 수송됩니다. 한편 챔버 가장자리에서는 전기장 분포와 입자 밀도에 편차가 생기기 쉬워 막 두께 균일성에 영향을 줄 가능성이 있습니다.
그림 3: 플라즈마 이온의 거동과 전기장 분포
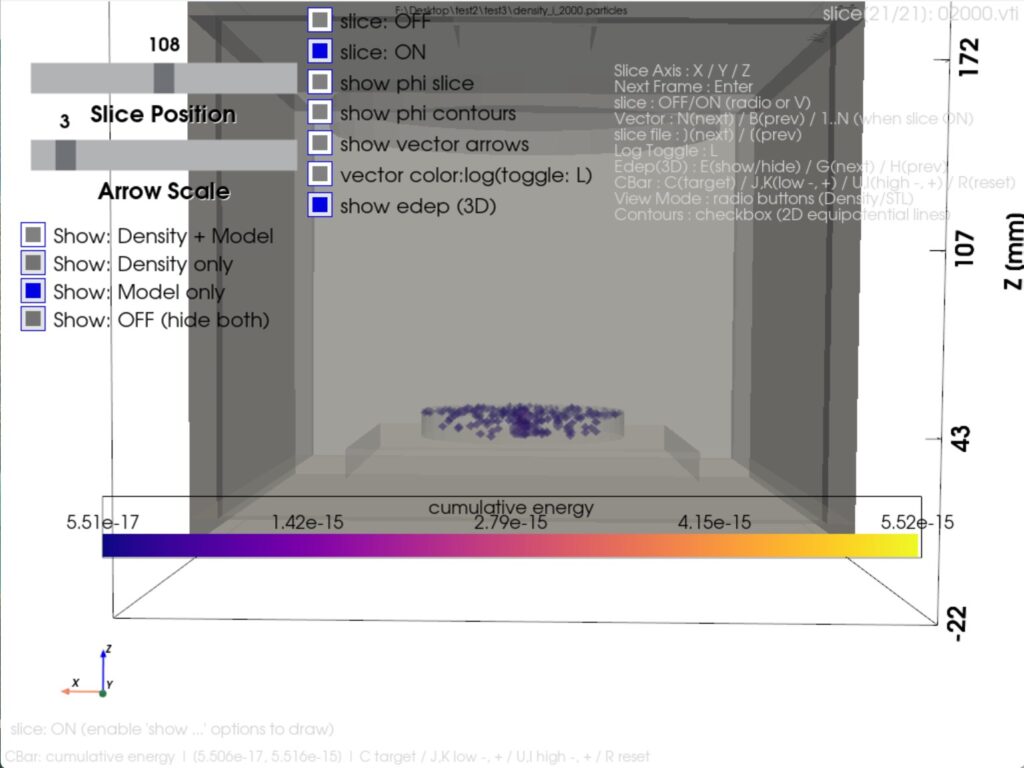
그림 4: 타깃에 대한 누적 입자 충돌 에너지
이러한 해석을 통해 다음과 같은 설계 검토로 이어질 수 있습니다.
- 샤워헤드 위치 및 개구 분포 재검토
- 스테이지 높이 및 전극 간 거리 최적화
- 챔버 치수와 방전 공간의 균형 검토
- 기판 전체 면적에서의 증착 균일성 향상
- 과도한 이온 충격 억제를 통한 막 손상 저감

이번 모델은 단순화된 해석용 CAD이기 때문에 실제 장비의 가스 유로, 고주파 급전부, 표면 반응의 상세까지는 생략되어 있습니다. 하지만 PIC-PLASMA 3D를 사용하면 장치 형상이 플라즈마 분포와 기판 근방의 입자 거동에 미치는 영향을 사전에 확인할 수 있습니다.
정리
플라즈마 CVD는 플라즈마에서 생성된 활성종과 이온을 이용해 비교적 낮은 온도에서 고기능 박막을 형성할 수 있는 중요한 공정입니다. 한편, 증착 균일성과 막질은 장치 내부의 플라즈마 분포와 기판 근방의 전기장 구조에 크게 좌우됩니다.
PIC-PLASMA 3D를 활용하면 플라즈마 CVD 장치 내부의 방전 영역, 입자 수송, 전기장 분포를 시각화하여 장치 설계와 조건 최적화 검토에 도움이 됩니다.
- 플라즈마 밀도의 공간 분포 확인
- 전기장 벡터 시각화
- 입자 궤적 확인
- 기판 근방 도달 경향 평가
- 장치 형상 변경 시 비교 검토
플라즈마 CVD 장치의 초기 설계와 증착 조건 검토에 PIC-PLASMA 3D를 꼭 활용해 보세요.