什么是等离子体CVD?
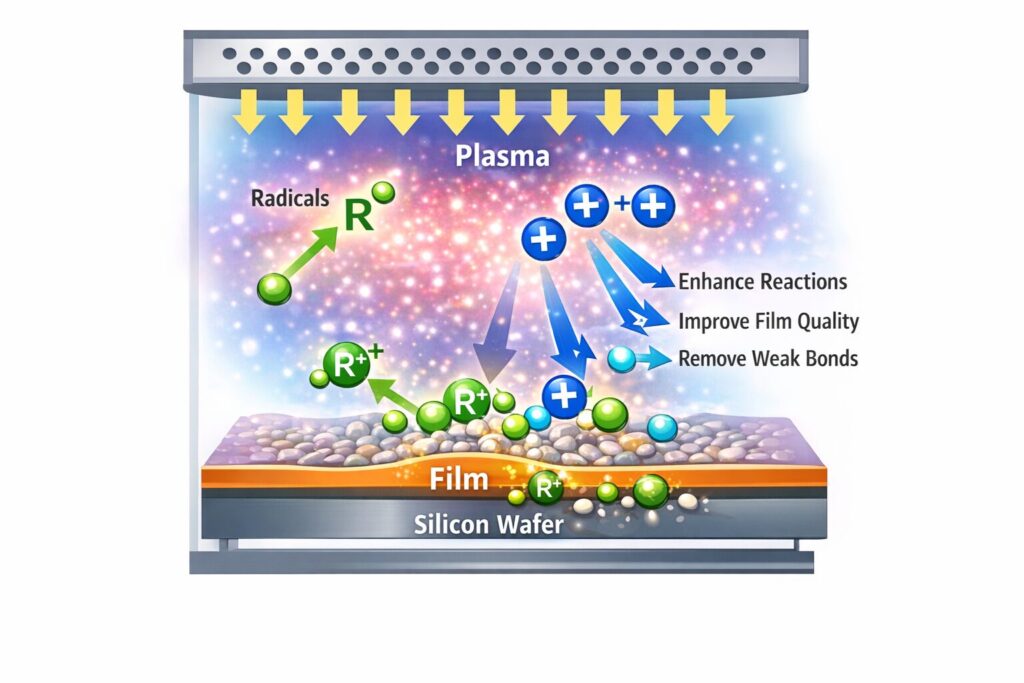
在薄膜形成过程中,将材料均匀沉积在基板表面非常重要。等离子体CVD是一种利用等离子体活化原料气体,并在基板表面发生化学反应来形成薄膜的方法。
与主要依靠热来推动反应的普通CVD相比,等离子体CVD即使在相对较低的温度下也更容易促进反应。因此,它被广泛应用于半导体膜、绝缘膜和保护膜的形成。



本文将使用 PIC-PLASMA 3D(等离子体分析软件),分析工业等离子体CVD装置内部的等离子体分布,以及粒子到达基板附近的趋势。
等离子体CVD装置的基本原理
等离子体CVD装置是一种利用等离子体活化反应性气体,并在基板表面生长薄膜的设备。例如,引入 SiH4、NH3、O2 等原料气体,并施加RF功率进行放电,从而生成离子、电子和自由基。
其基本原理如下:
- 将原料气体和稀释气体导入真空腔体
- 在上部电极或淋浴头与下部载台之间施加高频电力
- 电子与气体分子碰撞,引发电离、激发和解离,形成等离子体
- 生成的自由基和离子向基板方向输运
- 在基板表面发生吸附、反应和再结合,从而形成薄膜
自由基的作用:等离子体中生成的中性自由基在基板表面的化学反应中起着重要作用。它们作为成膜所需的前驱体,会影响薄膜组成和沉积速率。
离子的作用:离子会在基板附近的鞘层电场中被加速并到达表面。过强的离子轰击可能导致薄膜损伤和缺陷增加,而适度的离子辅助则有助于改善膜质和致密化。
也就是说,在等离子体CVD中,必须适当控制负责化学反应的自由基输运以及影响表面状态的离子入射。
等离子体CVD分析中需要观察什么
在等离子体CVD装置中,不仅沉积速率重要,膜厚分布、膜质、基板损伤以及装置内部反应均匀性也同样重要。因此,通过仿真掌握以下内容很有价值:
- 腔体内的等离子体密度分布
- 基板上方的电位和电场分布
- 离子到达方向和能量趋势
- 从气体入口到基板的粒子输运偏差
- 影响成膜均匀性的空间分布
特别是当希望在整个基板表面上均匀形成薄膜时,放电区域的扩展方式、淋浴头形状、载台位置以及腔体尺寸之间的平衡就非常重要。
等离子体CVD装置内部的等离子体分布分析
下面使用 PIC-PLASMA 3D 来确认等离子体CVD装置内部的放电区域,以及粒子向基板附近输运的趋势。
分析模型
本次分析采用了一个简化的等离子体CVD反应器模型:上部设有兼作气体导入机构的淋浴头电极,下部设有基板载台。与制造用详细CAD不同,这里优先采用便于把握等离子体生成区域、鞘层形成区域以及基板附近区域的分析模型。
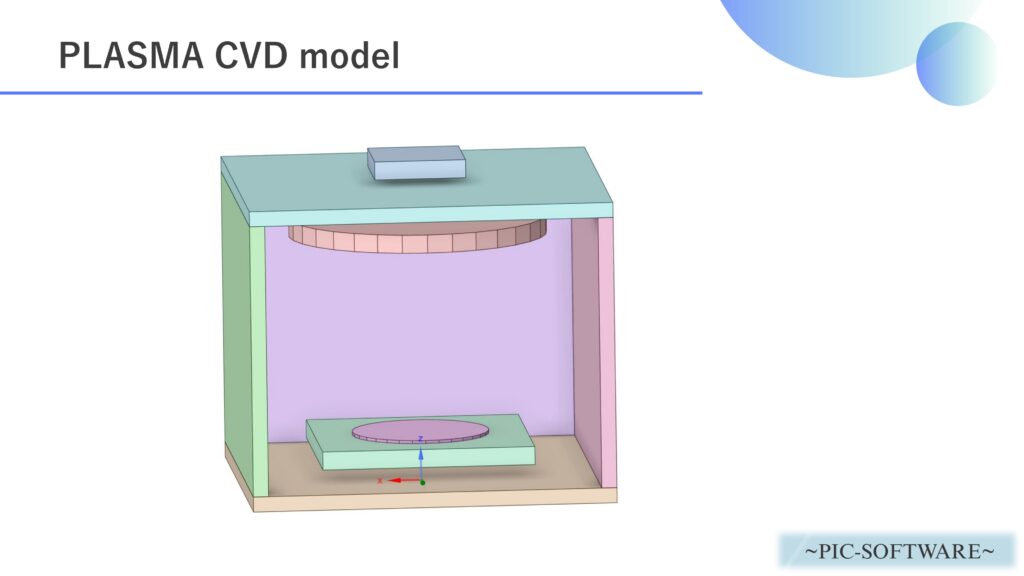
图1:等离子体CVD装置的分析模型
在该模型中,假设从气体入口供给的原料气体在上部区域发生放电,所生成的离子、电子和自由基向基板方向输运。

分析条件
分析条件如下。
| 分析软件 | PIC-PLASMA 3D |
| 分析类型 | 等离子体分析 |
| 分析对象 | plasma_cvd_reactor.obj |
| 目标工艺 | 等离子体CVD |
| 代表气体种类 | O2 |
| 等离子体密度 | 1.0×106 [个/m3] |
| 施加条件 | 模拟上部电极施加RF时的电位差条件 |
| 时间步长 | 1.0×10-8 [s] |
| 总仿真时间 | 2.0×10-5 [s] |
| 关注项目 | 等离子体分布、电场分布以及基板附近粒子到达趋势 |
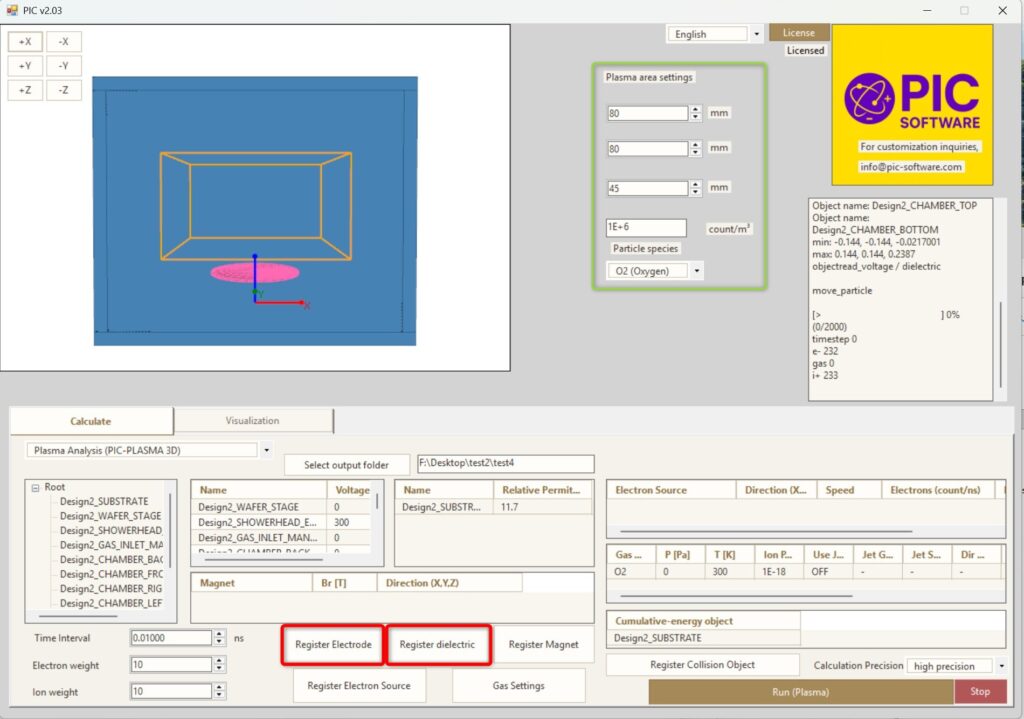
实际成膜过程中,气体反应和表面反应的详细建模也很重要,但本模型首先重点放在掌握装置内部的放电结构和粒子输运趋势上。

分析结果
作为分析结果的一个示例,可以确认在腔体内部,从上部淋浴头附近到基板上方形成了放电区域,并在电极之间 확보了较宽的等离子体生成空间。
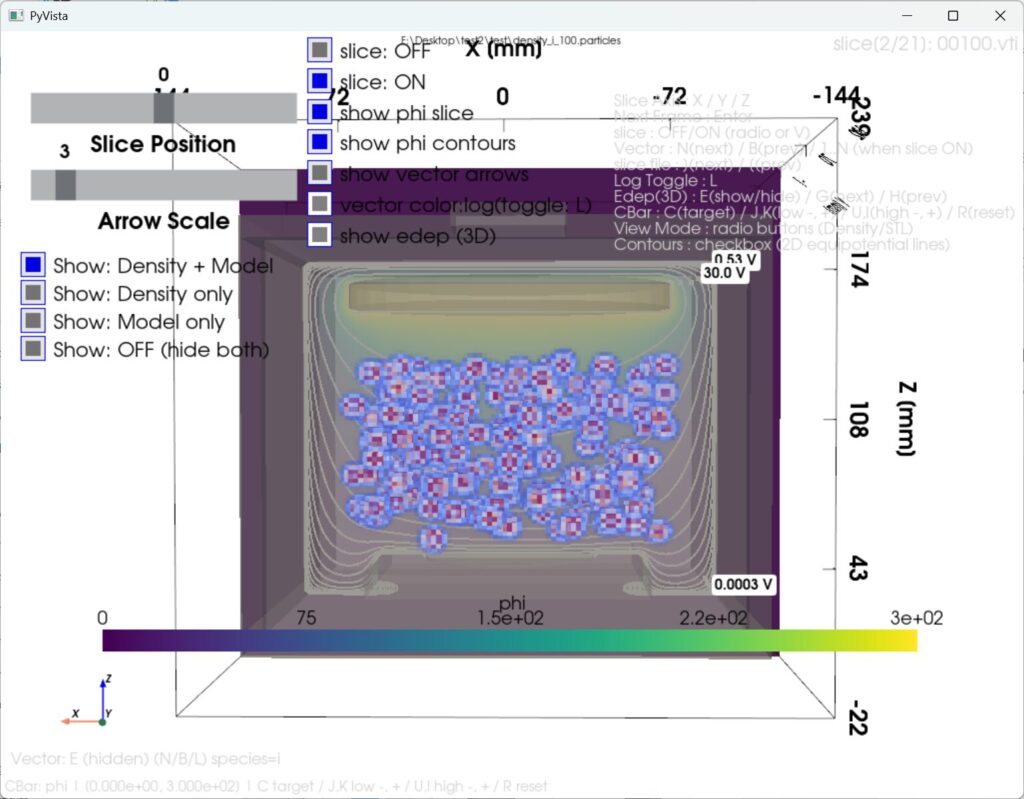
图2:等离子体CVD装置内的离子密度与电场
此外,在基板附近,由于鞘层形成,电场增强,离子更容易向基板方向输运。另一方面,在腔体边缘,电场分布和粒子密度容易出现偏差,这可能会影响膜厚均匀性。
图3:等离子体离子的行为与电场分布
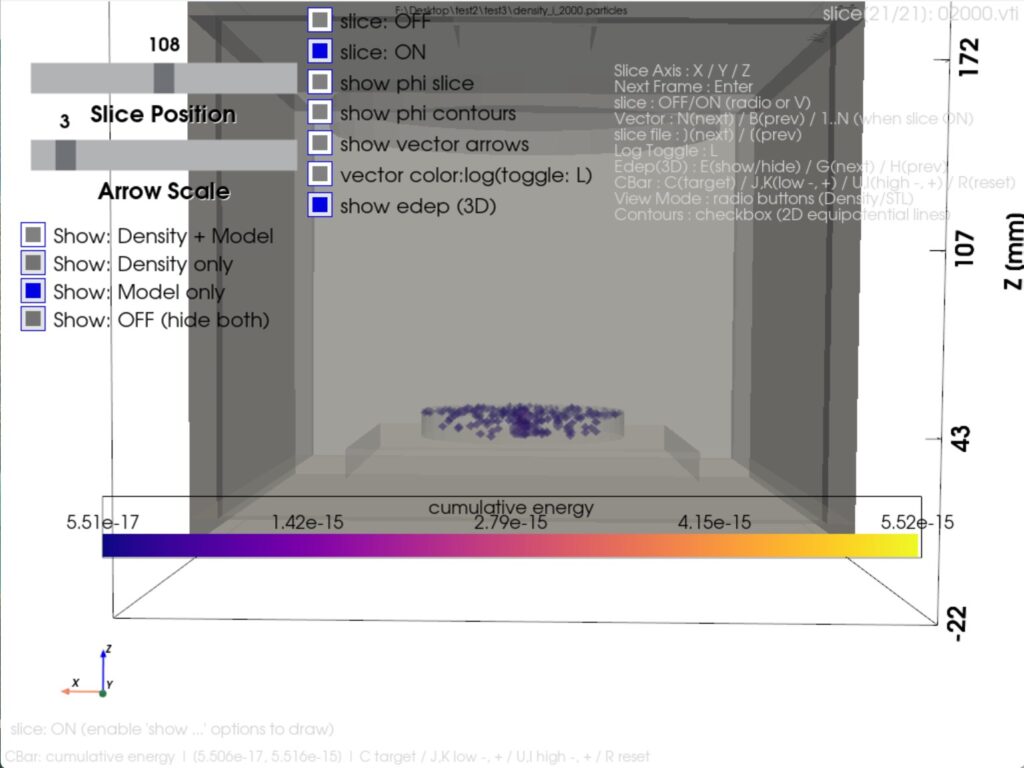
图4:粒子在靶材上的累积碰撞能量
通过这类分析,可以进一步开展如下设计研究:
- 重新评估淋浴头位置与开口分布
- 优化载台高度和电极间距
- 研究腔体尺寸与放电空间之间的平衡
- 提高整个基板表面的成膜均匀性
- 通过抑制过强的离子轰击来减少薄膜损伤

本次模型是用于分析的简化CAD模型,因此省略了实际气体流路、高频供电部以及表面反应细节等内容。不过,通过使用 PIC-PLASMA 3D,可以事先确认装置形状对等离子体分布以及基板附近粒子行为的影响。
总结
等离子体CVD是一种重要工艺,它利用等离子体中生成的活性种和离子,在相对较低温度下形成高性能薄膜。同时,成膜均匀性和膜质量会受到装置内部等离子体分布以及基板附近电场结构的显著影响。
通过使用 PIC-PLASMA 3D,可以将等离子体CVD装置内部的放电区域、粒子输运和电场分布可视化,从而为设备设计和工艺条件优化提供帮助。
- 确认等离子体密度的空间分布
- 电场矢量可视化
- 确认粒子轨迹
- 评估到达基板附近的趋势
- 改变装置形状时进行对比研究
在等离子体CVD装置的初期设计和成膜条件研究中,欢迎使用 PIC-PLASMA 3D。