什么是等离子体

图1:物质的四种状态
通常,物质被分为固体、液体和气体,但如果进一步加热气体,就有可能产生等离子体。
因此,等离子体被称为物质的“第四种状态”。



这次我们将使用 PIC-PLASMA 3D(等离子体分析软件) 来分析工业用等离子体刻蚀设备。
等离子体刻蚀设备是一种利用等离子体中的活性种和离子去除材料表面的设备。在半导体制造中,它被广泛用于对硅、绝缘膜和金属膜进行微细加工。
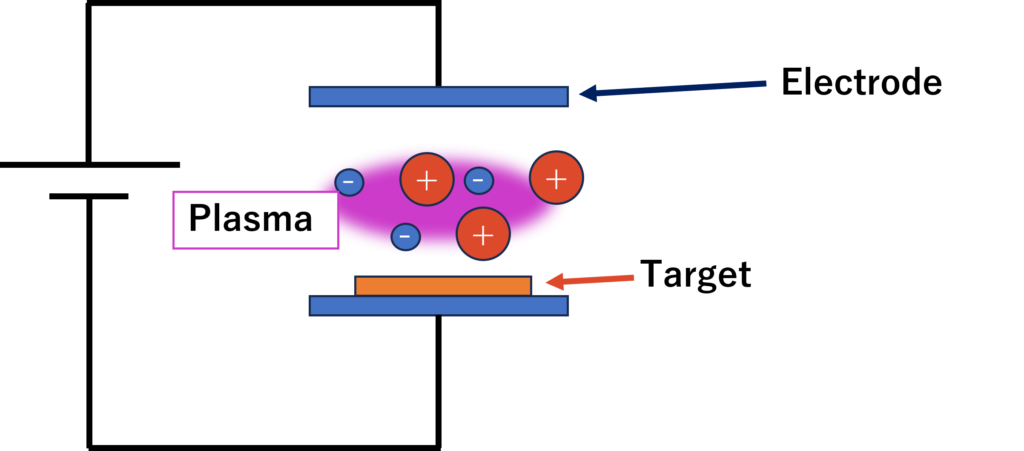
图2:等离子体刻蚀示意图
其基本原理如下:
- 将反应性气体导入真空腔体内,并施加高频电源。
- 使气体发生放电,产生等离子体。
- 通过化学作用和物理作用的结合去除目标材料。
化学作用是指在等离子体中生成的自由基与被加工材料表面发生反应,形成挥发性的生成物。例如,当含氟自由基与硅反应时,会生成易于以气体形式排出的产物,从而去除表面材料。
物理作用是指等离子体中的正离子在电场作用下被加速并朝基板方向运动,最终撞击表面。这种离子轰击会将表面原子打出,并促进反应进行。因此,可以实现仅靠化学反应难以获得的各向异性刻蚀,也就是主要沿垂直方向向下刻蚀。
在设备内部,通过对放置基板的电极施加高频电压,会产生自偏压,从而使离子更容易几乎垂直地入射到基板表面。因此,可以在不横向扩展微细图形的情况下进行深而精确的加工。
等离子体刻蚀设备的特点包括:
- 适合微细加工
- 可实现各向异性加工
- 通过选择反应气体,可实现对不同材料的选择性
这就是其主要优势。
另一方面,
- 过度离子轰击导致的基板损伤
- 掩膜损耗
- 反应生成物再附着
也是其面临的课题。
简而言之,等离子体刻蚀设备是一种利用真空中产生的等离子体的化学反应性和离子轰击,对材料表面进行精密去除的设备。
等离子体刻蚀设备中目标物的负载分析
下面我们使用 PIC PLASMA 3D 来进行等离子体刻蚀设备内部等离子体对目标物碰撞的仿真分析。
分析模型如下。
分析模型
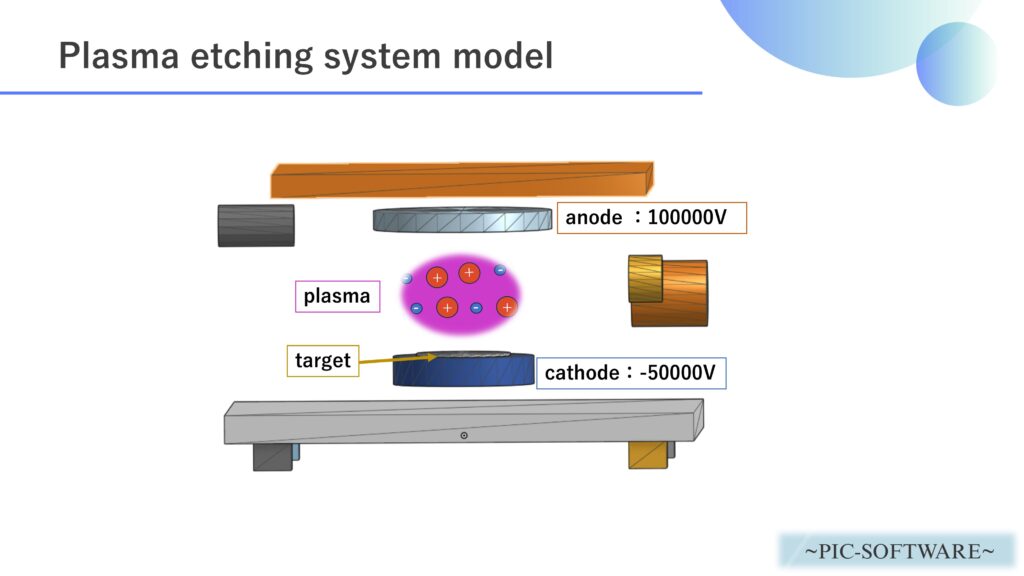
图3:等离子体刻蚀设备分析模型
我们建立了上述等离子体刻蚀设备模型,并对腔体内等离子体的轨迹进行了分析。
另外,等离子体的产生机制如下所示。

图4:等离子体生成过程
分析条件
分析条件如下所示。
| 分析软件 | PIC-PLASMA 3D |
| 分析类型 | 等离子体分析 |
| 分析对象 | plasma_etcher.step |
|---|---|
| 等离子体粒子种类 | Ar |
| 等离子体密度 | 1.0×107 [个/m3] |
| 累计能量目标对象 | input004 |
| 电压 | 阴极电压:-50000 [V] 阳极电压:100000 [V] |
| 时间步长 | 5.0×10-10 [s] |
| 总仿真时间 | 1.0×10-6 [s] |

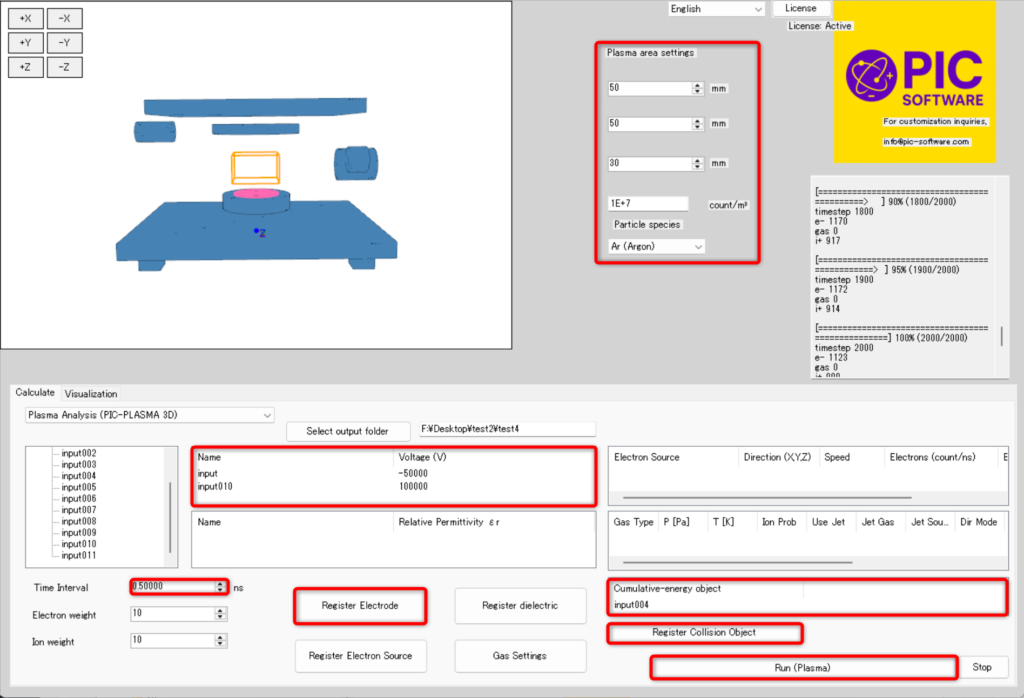
图5:PIC-PLASMA 3D中的分析条件设置
分析结果
图6:等离子体刻蚀设备内部的等离子体分析结果
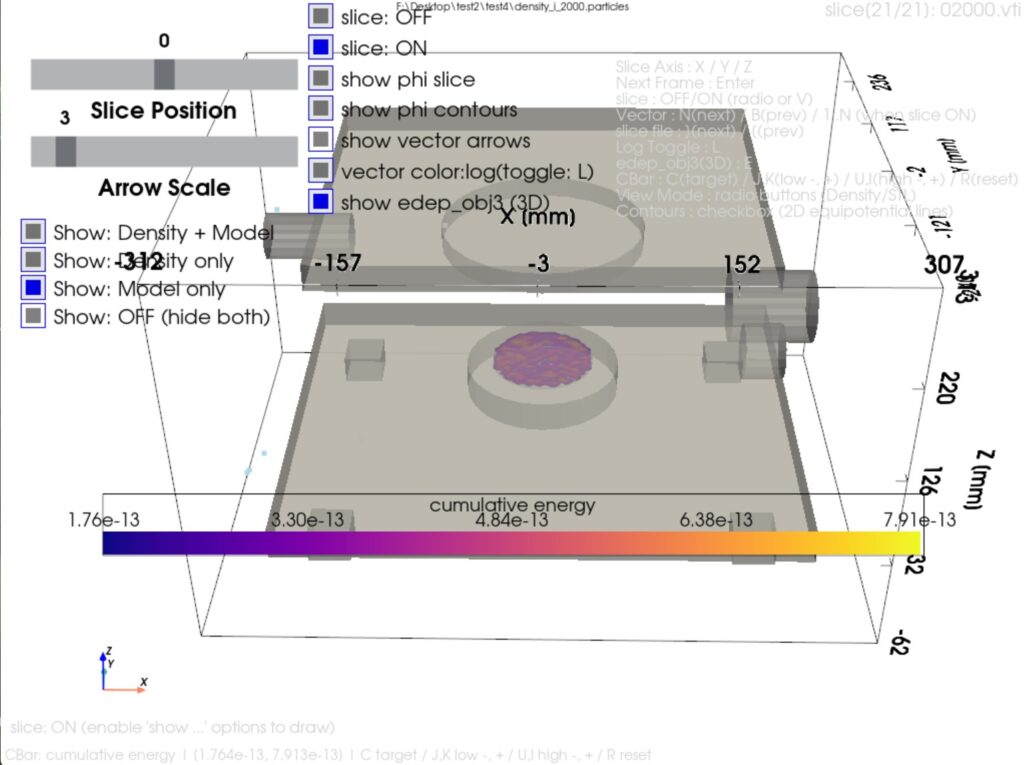
图7:目标等离子体的累计碰撞能量
以上资料是使用 PIC-PLASMA 3D 实际计算得到的分析结果。
图6以动画形式可视化了等离子体中离子(Ar+)的行为。
图7显示了目标与等离子体之间的累计碰撞能量(动能)。


另外,本次使用的 CAD 模型是简化制作的,因此电极电压及其他条件设置也进行了简化。
此外,PIC-PLASMA 3D 除了上述计算结果外,还可以输出各种数据。
- 电子密度
- 电流密度矢量
- 电场矢量
- 速度矢量
- 背景气体和喷射气体中与等离子体的碰撞
※以上仅为示例。欢迎在等离子体产品开发中积极使用 PIC-PLASMA 3D。