プラズマとは

図1:物質の4つの状態
よく物質は固体・液体・気体に分けられますが、気体をさらに加熱することでプラズマを生み出すことが可能です。
そのため、プラズマは物質の『第4の状態』と表現されます。



今回は、PIC-PLASMA 3D(プラズマ解析ソフト)で産業用製品のプラズマエッチング装置を解析してみます。
プラズマエッチング装置は、プラズマ中の活性種やイオンを利用して材料表面を削る装置です。半導体製造では、シリコンや絶縁膜、金属膜を微細加工するために広く使われます。
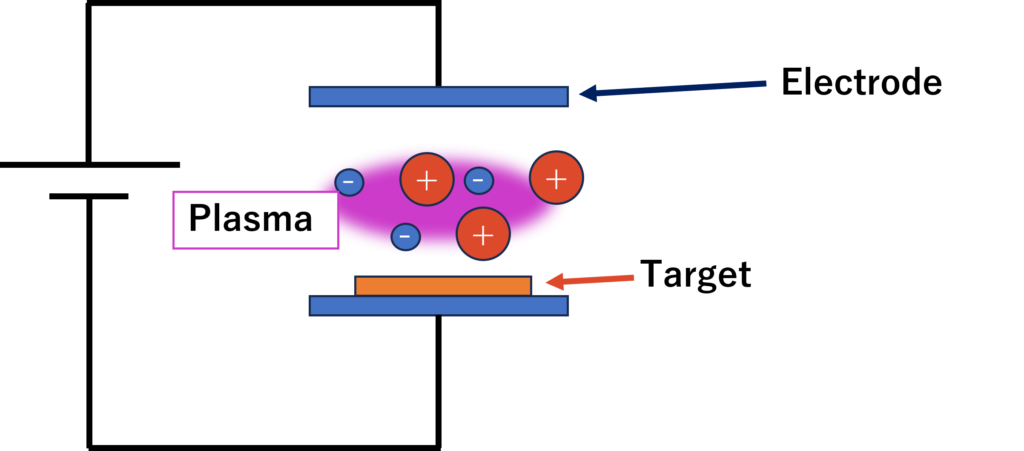
図2:プラズマエッチングの概念図
基本原理は下記の通りです。
- 真空容器内に反応性ガスを導入し、そこに高周波電力を加える
- ガスを放電させ、プラズマを発生させる。
- 化学的作用 と 物理的作用 の組み合わせでターゲット材料を削る
化学的作用では、プラズマ中で生成されたラジカルが被加工材料の表面と反応し、揮発性の生成物を作ります。たとえば、シリコンにフッ素系ラジカルが反応すると、気体として排気しやすい生成物になり、表面が除去されます。
物理的作用では、プラズマ中の正イオンが電界によって基板側に加速され、表面に衝突します。このイオン衝撃により表面原子がたたき出されたり、反応が促進されたりします。これによって、単なる化学反応だけでは得にくい異方性エッチング、つまり縦方向に掘り進める加工が可能になります。
装置内部では、基板を置く電極に高周波を印加することで自己バイアス電圧が生じ、イオンが基板へほぼ垂直に入射しやすくなります。そのため、微細なパターンを横に広げず、深く正確に加工できます。
プラズマエッチング装置の特徴は、
- 微細加工に適している
- 異方性加工ができる
- 反応ガスを選ぶことで材料ごとの選択性を持たせられる
という点です。
一方で、
- 過剰なイオン衝撃による基板損傷
- マスクの消耗
- 反応生成物の再付着
などが課題になります。
要するに、プラズマエッチング装置は、真空中で発生させたプラズマの化学反応性とイオン衝撃を利用して、材料表面を精密に除去する装置です。
プラズマエッチング装置内におけるターゲットへの負荷解析
PIC PLASMA 3Dを用いて、プラズマエッチング装置内のプラズマにおけるターゲットへの衝突シミュレーションをしてみましょう。
解析モデルは下記の通り。
解析モデル
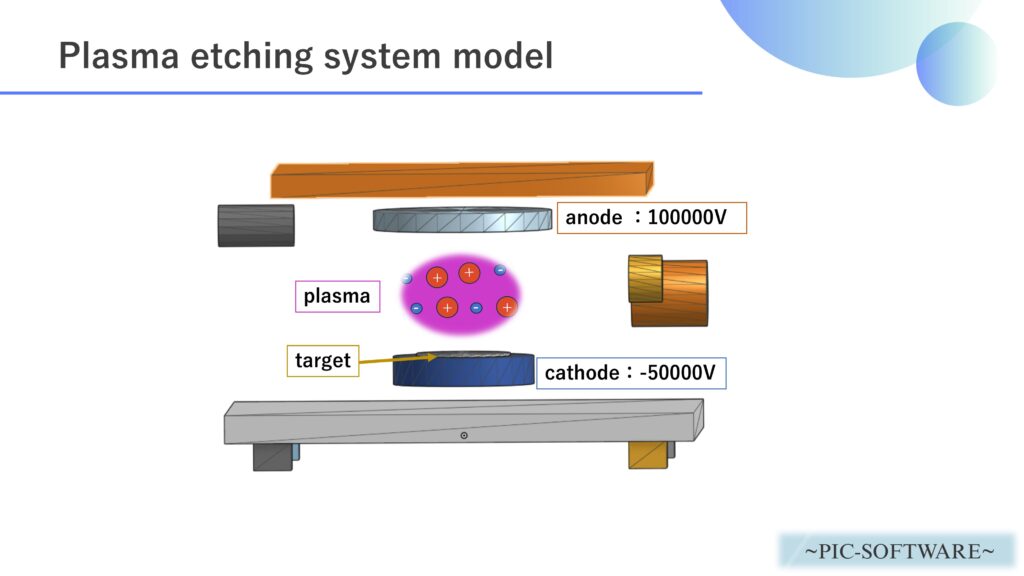
図3:プラズマエッチング装置の解析モデル
上記のようなプラズマエッチング装置モデルを作成し、チャンバー内のプラズマの軌道解析を実施しました。
なお、プラズマの発生機構は下記の通りです。

図4:プラズマの生成過程
解析条件
解析条件は以下の通りです。
| 解析ソフト | PIC-PLASMA 3D |
| 解析タイプ | プラズマ解析 |
| 解析オブジェクト | plasma_etcher.step |
|---|---|
| プラズマ粒子種 | Ar |
| プラズマ密度 | 1.0×107[個/m3] |
| 累積エネルギー対象オブジェクト | input004 |
| 電圧 | 陰極電圧:-50000[V] 陽極電圧:100000[V] |
| 時間刻み幅 | 5.0×10-10[s] |
| 総シミュレーション時間 | 1.0×10-6[s] |

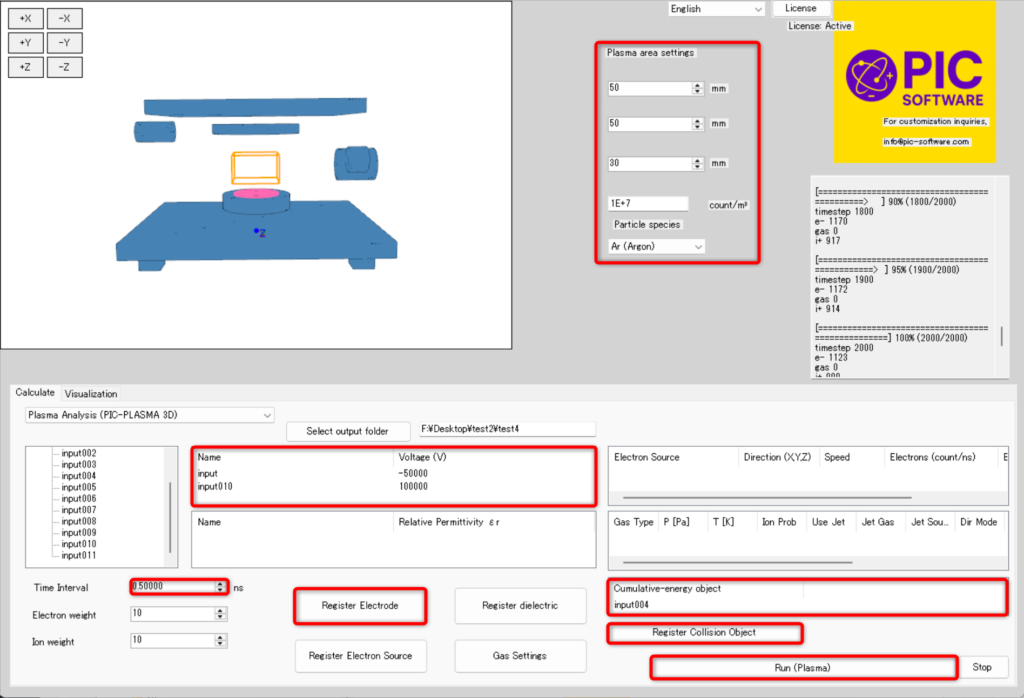
図5:PIC-PLASMA 3Dにおける解析条件の設定
解析結果
図6:プラズマエッチング装置内におけるプラズマの解析結果
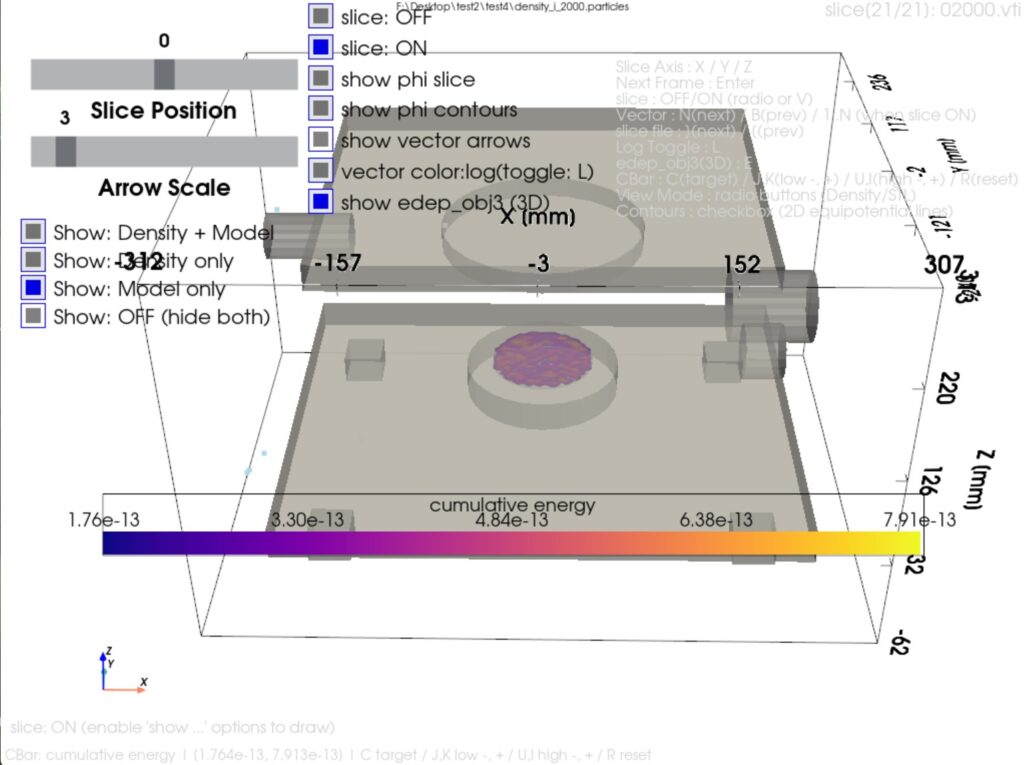
図7:ターゲットプラズマの累積衝突エネルギー
上記資料は、実際にPIC-PLASMA3Dで計算した実際の解析結果です。
図6は、プラズマ内のイオン(Ar+)の振る舞いをアニメーションで可視化しています。
図7は、ターゲットとプラズマの累積衝突エネルギー(運動エネルギー)を示しています。


なお、今回用いたcadモデルは簡易的に作成したものであるため、電極電圧やその他の条件設定は簡略化しています。
また、PIC-PLASMA 3Dでは、上記の計算結果に加えて、さまざまなデータを出力することができます。
- 電子密度
- 電流密度ベクトル
- 電場ベクトル
- 速度ベクトル
- 背景ガスやジェットガスにおけるプラズマとの衝突
※上記は一例です。 プラズマ製品の開発にPIC-PLASMA 3Dを是非ご活用ください。