プラズマCVDとは
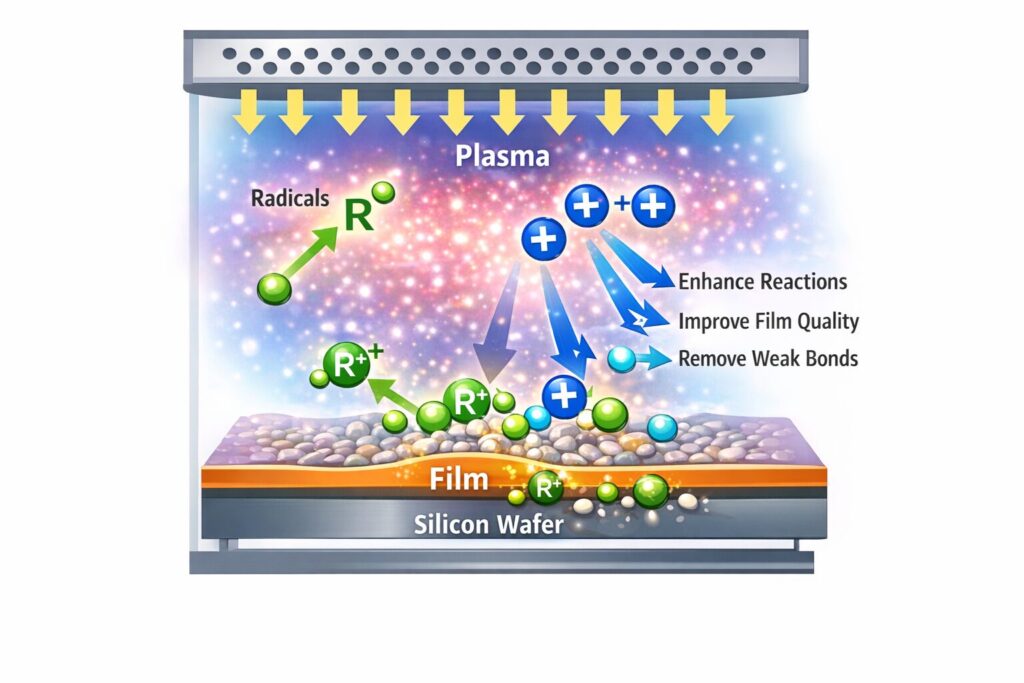
よく薄膜形成では、材料を基板の上に均一に積み重ねていくことが重要になります。プラズマCVDは、原料ガスをプラズマで活性化し、基板表面で化学反応を起こすことで薄膜を形成する方法です。
熱だけで反応を進める通常のCVDと比べると、プラズマCVDは比較的低温でも反応を進めやすく、半導体・絶縁膜・保護膜などの形成に広く使われています。



今回は、PIC-PLASMA 3D(プラズマ解析ソフト)を用いて、産業用プラズマCVD装置内のプラズマ分布と基板近傍への粒子到達傾向を解析してみます。
プラズマCVD装置の基本原理
プラズマCVD装置は、反応性ガスをプラズマによって活性化し、基板表面で薄膜を成長させる装置です。たとえばSiH4やNH3、O2などの原料ガスを導入し、RF電力で放電させることで、イオン・電子・ラジカルを生成します。
基本原理は下記の通りです。
- 真空チャンバー内に原料ガスと希釈ガスを導入する
- 上部電極またはシャワーヘッドと下部ステージの間に高周波電力を印加する
- 電子がガス分子と衝突し、電離・励起・解離を起こしてプラズマを形成する
- 生成されたラジカルやイオンが基板近傍へ輸送される
- 基板表面で吸着・反応・再結合が起こり、薄膜が形成される
ラジカルの役割:プラズマ中で生成された中性ラジカルは、基板表面での化学反応に大きく関与します。膜形成に必要な前駆体として働き、組成や成膜速度に影響を与えます。
イオンの役割:イオンは基板近傍のシース電界で加速されて表面に到達します。過度に強いイオン衝撃は膜ダメージや欠陥増加につながる一方、適度なイオンアシストは膜質改善や緻密化に寄与します。
つまり、プラズマCVDでは化学反応を担うラジカル輸送と表面状態に影響するイオン入射の両方を適切に制御することが重要になります。
プラズマCVD解析で何を見るのか
プラズマCVD装置では、成膜速度だけでなく、膜厚分布・膜質・基板ダメージ・装置内の反応均一性が重要です。そのため、シミュレーションでは次のような点を把握する価値があります。
- チャンバー内のプラズマ密度分布
- 基板上方の電位・電場分布
- イオンの到達方向とエネルギー傾向
- ガス導入口から基板までの粒子輸送の偏り
- 成膜の均一性に影響する空間分布
特に、基板全面で均一に薄膜を形成したい場合、放電領域の広がり方やシャワーヘッド形状、ステージ位置、チャンバー寸法のバランスが重要になります。
プラズマCVD装置内におけるプラズマ分布解析
PIC-PLASMA 3Dを用いて、プラズマCVD装置内における放電領域と基板近傍への粒子輸送傾向を確認してみましょう。
解析モデル
今回の解析では、上部にガス導入機構を兼ねたシャワーヘッド電極、下部に基板ステージを持つ簡略化プラズマCVDリアクタを対象としました。製造用の詳細CADではなく、プラズマ生成領域・シース形成領域・基板近傍領域を把握しやすい解析向けモデルを優先しています。
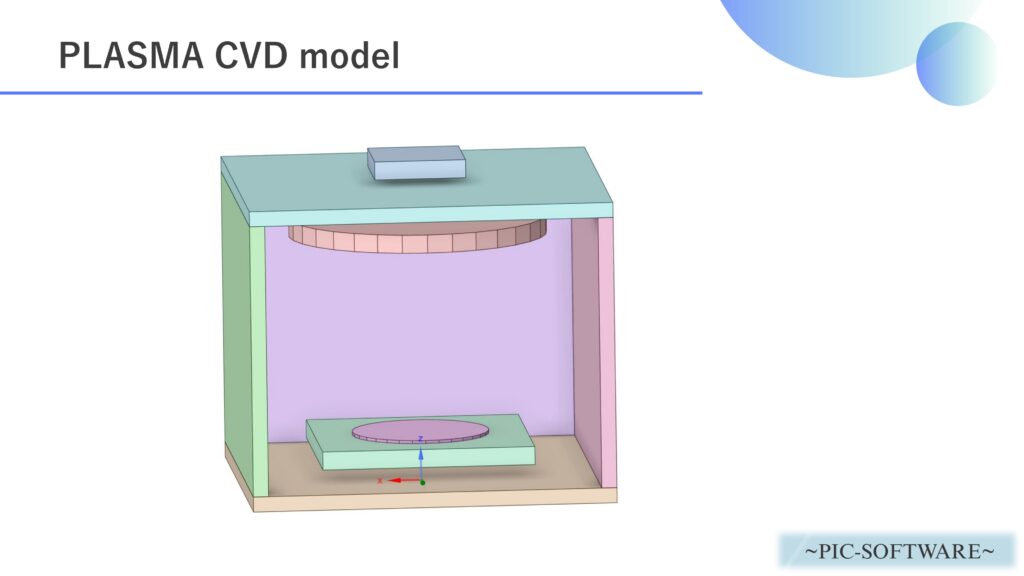
図1:プラズマCVD装置の解析モデル
モデル内では、ガス導入口から供給された原料ガスが上部領域で放電し、生成されたイオン・電子・ラジカルが基板方向へ輸送されることを想定しています。

解析条件
解析条件は以下の通りです。
| 解析ソフト | PIC-PLASMA 3D |
| 解析タイプ | プラズマ解析 |
| 解析オブジェクト | plasma_cvd_reactor.obj |
| 対象プロセス | プラズマCVD |
| 代表ガス種 | O2 |
| プラズマ密度 | 1.0×106[個/m3] |
| 印加条件 | 上部電極RF印加を模擬した電位差条件 |
| 時間刻み幅 | 1.0×10-8[s] |
| 総シミュレーション時間 | 2.0×10-5[s] |
| 着目項目 | プラズマ分布、電場分布、基板近傍粒子到達傾向 |
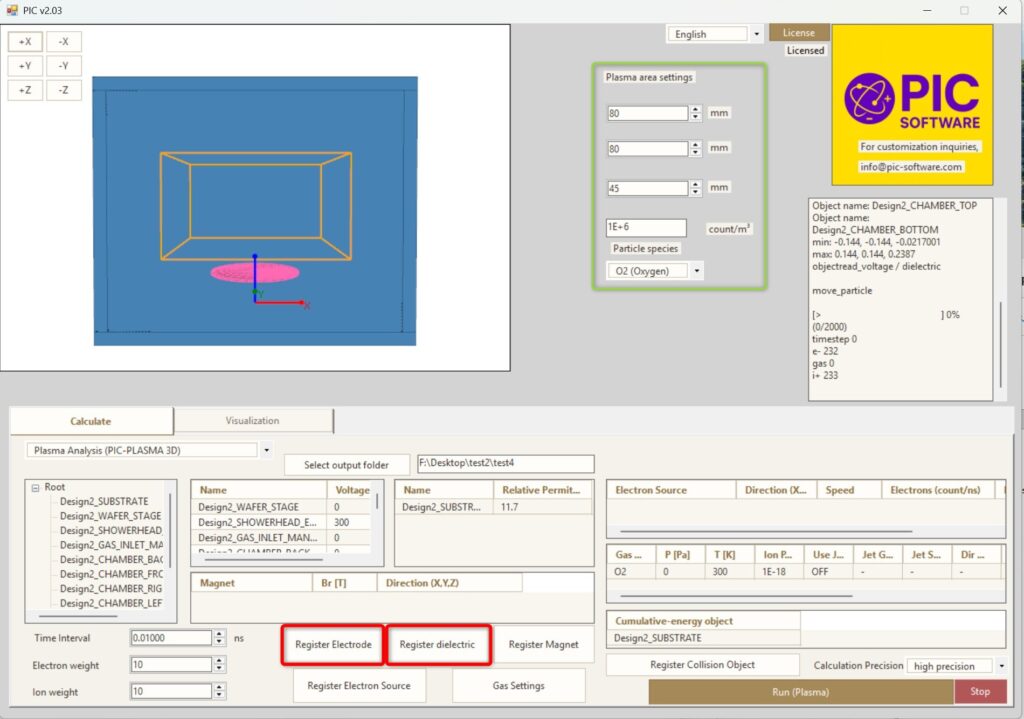
なお、実際の成膜ではガス反応や表面反応の詳細モデル化も重要ですが、今回のモデルではまず装置内部の放電構造と粒子輸送傾向の把握に重点を置いています。

解析結果
解析結果の一例として、チャンバー内部では上部シャワーヘッド近傍から基板上方にかけて放電領域が形成され、電極間で比較的広いプラズマ生成空間が確保されることが確認できます。
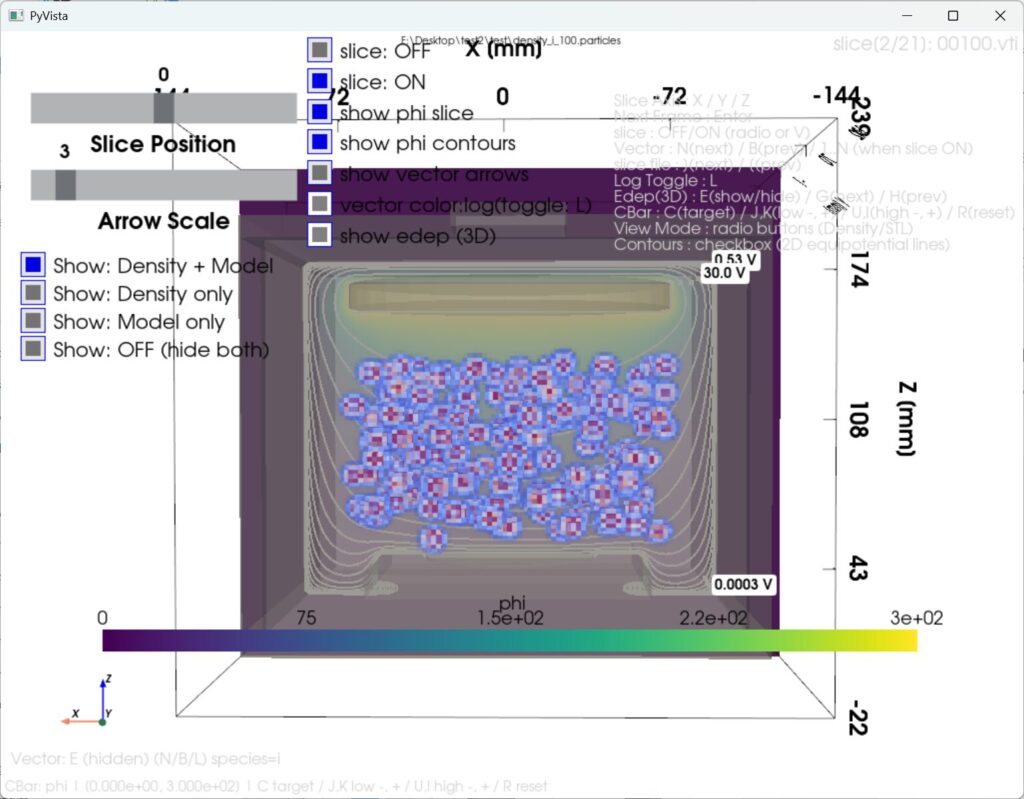
図2:プラズマCVD装置内におけるイオン密度と電場
また、基板近傍ではシースの形成により電場が強まり、イオンが基板方向へ輸送されやすくなります。一方で、チャンバー端部では電場分布や粒子密度に偏りが生じやすく、膜厚均一性に影響する可能性があります。
図3:プラズマイオンの振る舞い・電場分布
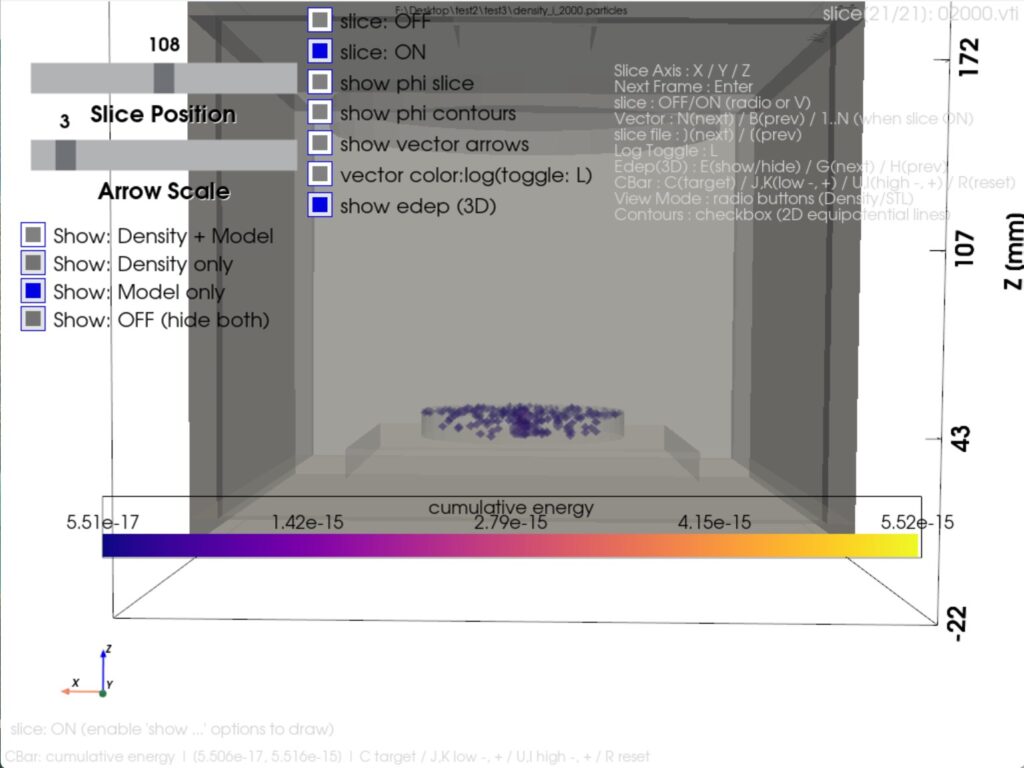
図4:ターゲットへの累積の粒子衝突エネルギー
このような解析により、以下のような設計検討につなげることができます。
- シャワーヘッド位置や開口分布の見直し
- ステージ高さ・電極間距離の最適化
- チャンバー寸法と放電空間のバランス検討
- 基板全面での成膜均一性向上
- 過大なイオン衝撃の抑制による膜ダメージ低減

今回のモデルは簡略化した解析用CADであるため、実機のガス流路や高周波給電部、表面反応の詳細までは省略しています。ただし、PIC-PLASMA 3Dを用いることで、装置形状がプラズマ分布や基板近傍の粒子挙動に与える影響を事前に確認することができます。
まとめ
プラズマCVDは、プラズマ中で生成された活性種とイオンを利用して、比較的低温で高機能な薄膜を形成できる重要なプロセスです。一方で、成膜の均一性や膜質は、装置内部のプラズマ分布や基板近傍の電場構造に大きく左右されます。
PIC-PLASMA 3Dを活用することで、プラズマCVD装置内の放電領域、粒子輸送、電場分布を可視化し、装置設計や条件最適化の検討に役立てることができます。
- プラズマ密度の空間分布確認
- 電場ベクトルの可視化
- 粒子軌道の確認
- 基板近傍への到達傾向評価
- 装置形状変更時の比較検討
プラズマCVD装置の初期設計や成膜条件検討に、ぜひPIC-PLASMA 3Dをご活用ください。